MEMS
기술 및 시장 동향

1. 개요
MEMS(Micro Electro Mechanical
Systems)는 입체적인 미세구조와 회로, 센서와 액추에이터를 실리콘
기판 위에 집적화 시킨 것으로 소형이면서도 복잡하여 고도의 동작을 하는 시스템으로 마이크로시스템이나 마이크로머신 등으로 불리기도 한다. MEMS는 반도체 집접회로의 구조 기술을 기본으로 하고, 전자, 기계, 광, 재료 등
다양한 기술을 융합한 미세가공 기술로 제작되어, 소형화는 물론 집적화,
저전력 및 저가격 등 대부분의 전자, 기계 및 부품들이 궁극적으로 추구하는 목표를 모두
만족시킬 수 있다는 장점을 가지고 있다.
이제 21세기를 주도할 핵심기술 중 하나로 인식되고 있는 MEMS 기술은 우리가 흔히 접할 수 있는 정보기기 관련 시스템의 센서나 프린터 헤드와 같은 중요한 부분에 이용되고
있으며, 생명공학, 미세 유체 및 화학분석, 운송 및 항공, 광학, 그리고
로봇 등과 같은 산업 분야에서 구조, 부품 및 시스템 제조를 위한 핵심 기술로 활용되고 있다.
20여년에 불과한 역사를 가지고 있는 MEMS 기술은 기존의 다른 첨단기술에 비해 역사가 비교적 짧지만 다른 기술과의 융합과 접목을 통해 기존 시장을
효과적으로 대체하거나 새로운 시장을 창출할 무한한 잠재력이 있어, 1980년 초부터 미국, 유럽 및 일본 등 기술 선진국에서는 기술선점을 위해 국가적 차원에서 대형 연구개발 사업을 추진함과 동시에 특허를
통해 자국의 원천기술을 봉쇄하는데 심혈을 기울이고 있다.
MEMS 산업은 기술과 경험이 집약된
산업으로 시설 및 인력 등에 수백 억원의 자본투자가 필요하고 대부분의 기술이 특허에 걸려 있어 높은 연구개발 비용과 응용제품의 시스템 노하우까지
알아야 하는 등 사실상 시장 진입장벽이 높다고 할 수 있다. 그러나
MEMS시장은 대부분 새롭게 형성되는 단계이므로 새로 진입하는 업체들이 많아 MEMS 산업
내 기존 업체간 경쟁이 그렇게 심한 편은 아니다. 현재 국내에서는 대기업을 제외한 중소 및 벤처기업들이
높은 연구개발 및 생산설비 구축 비용, 그리고 시스템 노하우의 부족 등으로 시장 진입에 어려움을 겪고
있다. 시장 진입에 어려움을 겪는 또 다른 문제로는 인력을 들 수 있다. 그리고 외국 기업들은 시장을 주도하기 위해 국제 표준화 작업에 적극적으로 뛰어들고 있으나 국내 업체들은 이에
소극적인 편이며, 국제적인 인적교류도 활발하지 못해 최신 기술 및 제품 동향에 신속히 대응하지 못하고
업체간 전략적 제휴도 거의 이루어지지 않고 있다. 따라서 무엇보다 산학연의 협력과 지원체제 구축, 그리고 전문인력 양성과 공동 FAB 구축에 대한 정부의 전략적 정책지원이
무엇보다 필요한 실정이다.
2. MEMS 기술 동향
가. 기술 개요
일반적으로 MEMS는 마이크로(1㎛=10-6m) 단위의 작은 부품과 시스템으로
설계, 제작 및 응용되는데, 최소 수 mm(1mm=10-3m) 이상의 기존 기계 부품이나 시스템보다는 작고, 나노(1nm=10-9m) 영역의 분자 소자나
탄소 나노 튜브보다는 큰 영역에 속하고 있으며, 이보다 더 작은 영역은 NEMS(Nano Electro Mechanical Systems)로 분류하고 있다.
사진석판술(photolithography), CMOS, 그리고
기타 가공기술로 저렴하게 대량 생산할 수 있는 단일 칩 형태의 MEMS는 애플리케이션에 따라 액추에이터/센서 및 스마트 구조의 노드, IC와 안테나, 프로세서와 메모리, 상호접속 망(통신
버스), IO(input-output) 시스템 등을 통합할 수 있다.
MEMS 기술은 반도체 소자 제작 기술에서
파급된 기술로 막대한 초기 투자비, 제작공정, 장시간의 공정개발, 양산 체제로 양질의 제품 대량생산, 저비용으로 고성능 제품 개발, 뛰어난 신뢰성 및 재현성, 저전력으로 고속 동작, 그리고 폭 넓은 응용분야 등의 측면에서 상당한 유사성을 가지고 있으나, 반도체
소자와는 차별화 되는 특수한 첨단 제작공정이 필요하다
나. MEMS 가공 기술과 재료
MEMS 기술을 구체화 하는 주요 가공기술에는
표면 미세가공(surface micromachining), 몸체 미세가공(bulk micromachining), 그리고 나노머시닝(nanomachining)
등이 있으며, 이외에 레이저 미세가공(laser
micromachining), LIGA(Lithographie, Galvanoformung, Abformung) 및 방전 미세가공(electro discharge micromachining) 등이 있다((그림 1) 참조).
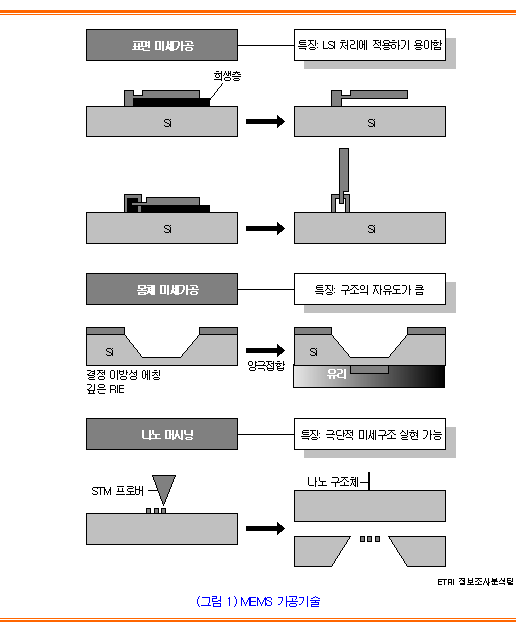
표면 미세가공은 희생층(sacrificial layer)을
식각(etching)으로 제거함으로써 기판 위에 기계적으로 움직이는 구조, 또는 경첩으로 서 있는 구조를 만드는 기술로 이전의 LSI 처리에
적용하기 쉬운 특징이 있다. 몸체 미세가공은 반응성 이온 식각법(RIE;
reactive ion etching) 등으로 깊게 식각하거나 양극접합이라고 부르는 방법으로 유리와 경합 시킴으로써 입체적인 구조체를
제작하는데, 구조의 자유도가 크다는 특징이 있다. 나노머시닝은
원자 수준의 나노 구조체를 제작한다. 식각법 등으로 나노 영역에 이르는 미세구조를 실현할 수 있지만, 주사형 터널 현미경(Scanning Tunneling Microscope;
STM)의 프로브 등으로 가공하는 것도 가능하다. 극단적으로 미세한 구조를 제작함으로써
높은 공간분해 성능과 고감도, 고속응답 등의 특징을 가진 시스템을 실현할 수 있다.
MEMS용 재료는 크게 구조체용 재료와
기능 재료로 구분할 수 있다. 구조체용 재료는 고강도/고인성 등 양호한 기계적 성질, 저비중, 내부식성/내환경성 등의 안정성, 미세가공에
의한 마이크로 구조의 용이한 제작, 마이크로 프로세서나 센서와의 집적화 가능, 대량생산 및 원활한 재료 공급 등과 같은 조건을 만족시켜야 하는데, 현재
이러한 구조적 특성을 가장 잘 만족하는 재료로는 실리콘을 꼽을 수 있다. 그러나 실리콘은 내마모성이
좋지않아 반복적인 마찰이 있는 기계부품에는 적당하지 않으며, 이런 경우에는 W(텅스텐), Mo(몰리브덴),
Ni(니켈) 및 Cu(구리) 등과 같은 금속계 재료들이 사용된다. 특히 상당한 내마모성이 요구되는
경우에는 Si3N4(질화실리콘)이나 DLC(Diamond-Like Carbon)와 같은 박막을 피복하기도 하고, 연성이
요구되는 경우 폴리이미드(Polyimide)와 같은 고분자 재료도 사용한다.
다. MEMS 설계 기술과 도구
MEMS 설계의 특징으로는 사용기술과
응용분야가 다양하다는 점과 제조와 제작 처리가 관련되어 있다는 점 등을 들 수 있다. MEMS는 시스템의
입출력부 등이 외부로 노출되어 사용되는 경우도 많기 때문에 실제 장착 시 문제가 많다. MEMS 설계는
구조에 관한 장치 설계와 제작에 관련된 처리 설계로 나눌 수 있다((그림 2) 참조). 장치 설계에서는 마스크 레이아웃을, 처리 설계에서는 처리 차트를 그린다. 시스템 설계로부터의 요구를
바탕으로 과거의 설계 자산과 설계 DB에 기초한 장치 시뮬레이터 등 설계 도구를 이용해 장치 설계가
이루어진다.
MEMS 장치는 깊은 식각 등의 특수한
처리로 제작되기 때문에 구조가 제작처리에 의존하는 비율이 높다. 따라서 장치 설계는 처리 설계와 연관되어
동시에 진행되며, 새로운 처리에 대해서는 기초 실험 등도 이루어진다.
시작품의 설계제작 단계에서 문제점이 발견되면 처음부터 다시 연구가 진행되는 경우도 있다.
최근의 MEMS 설계에서는 실장밀도와 정밀도 향상 측면에서
전기회로와 MEMS 구조의 융합이 필수적이다. 또한 MEMS라는 특별한 분야에 참여하고 있는 시스템 설계자, IC 레이아웃/회로 설계자, 장치 설계자, 처리
기술자 모두가 연대하여 개발작업을 진행할 필요성이 대두되고 있다. 이를 실현하기 위해서는 시스템에서
장치 및 처리에 이르기까지 폭 넓은 범위를 지원하는 MEMS 전용 도구가 필요하다.
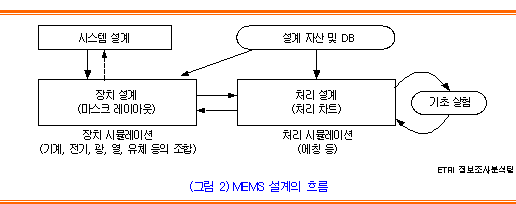
라. MEMS 기술의 주요 이슈와
전망
MEMS 분야에서 최근 떠오르는 이슈로는
막대한 설비 및 연구개발 투자가 필요한 MEMS 산업에서 제품 형태의 다양성에 따른 대량생산의 어려움과
소량생산에 의한 채산성 문제, 그리고 비즈니스 측면에서 이러한 문제점들을 극복할 수 있는 MEMS 전문 제조공장 구축 등을 들 수 있다.
현재 MEMS 기술에 의한 압력 센서와 가속도 센서 등은
대량생산으로 가격경쟁이 벌어지고 있으며, 프린터 헤드와 디스플레이용의
DMD 같은 부가가치가 높은 MEMS 제품도 있다. 그러나
요구는 있어도 수가 적어 채산성이 맞지 않아 출시되지 않는 MEMS 제품도 많다. MEMS는 처리 자체가 매우 복잡하여 표준화 하기 어렵고, 설계와
제조가 직결되기 때문에 현재의 Si 제조공장과 같은 형태를 채택하는 것이 어렵다. 그리고 완성된 칩 형태가 제 각각이기 때문에 후공정 설비를 공통화 하기 어렵고, 다이싱 등의 공정에서 칩 내부의 구조체가 파손될 가능성도 있다.
일반적으로 첨단 제품은 막대한 설비 투자와 연구개발 투자가 필요하기 때문에 대량생산이 전제가 되어야
하지만, 다품종 소량으로도 채산성을 맞출 수 있는 것이 앞으로 비즈니스의 성패를 결정할 것으로 보인다. 집적회로의 경우에는 표준화와 공통화가 쉽기 때문에 공장 구축도 진행되고 다품종 소량생산도 어느 정도 가능하다. 이에 대해 MEMS에서는 처리 등이 다양하고 게다가 장비 설계가
처리와 관계가 있기 때문에, 집적회로와 같이 설계 규칙에서 구별하여 처리를 블랙박스로 하고 시스템과
회로의 설계를 분리하는 것이 어렵다. 그러나 MEMS의 경우에도
표준화/공통화 하는 방향, 혹은 처리의 자유도를 크게 하는
방향으로 다품종 소량 공급을 할 필요가 있다.
다품종 소량생산 이슈와 관련해서 채산성을 높이기 위해서는 제조설비와 시제품 제작설비 등을 공유하고
기존 설비를 효과적으로 활용하여 비용을 절감할 필요가 있다. 또한 다른 분야의 다양한 정보와 기술을
융합해 단기간에 효율성이 높은 연구개발이 가능하도록 네트워크화 등으로 정보를 공유, 축적하여 이용하고
대학과 산업계가 연계하는 개방형 협동작업도 중요하다.
현재 전세계적으로 미국 17개, 독일 7개, 일본 6개, 대만 6개 등 54개의 FAB이 이미 구축되어 서비스를 실시하고 있다. 국내 MEMS 분야가 정부주도의 기술 연구에서 본격적인 산업으로
자리잡기 위해서는 MEMS 전용 FAB의 구축은 반드시 필요하다.
3. MEMS 시장 동향
가. 시장 개요
20여년의 짧은 역사에도 불구하고
MEMS 산업은 새로운 비즈니스 창출, 고용증대 및 신규 산업 부문으로의 애플리케이션 다양화
등을 통해 앞으로 5년 이내에 약 100억 달러 규모의 거대한
시장을 형성할 것으로 전망되고 있다. 반도체, 기계, 재료 및 전자 등 각종 첨단 공학기술의 집합체인 MEMS 제품에는
시판가격이 5∼20달러 정도의 비교적 단순한 센서를 비롯하여
밸브 및 노즐 등이 출시되어 있지만, 앞으로 1~2년 내에
매우 다양한 종류의 새로운 제품이 양산되어 관련업계의 판도가 크게 달라질 전망이다.
MEMS 분야에 대한 벤처 캐피털들의
관심이 높아지면서 지난 2000년에는 새로운 MEMS업체들에게
약 5억4,000만 달러를 지원하였는데, 이 중 81%를 통신용 MEMS 업체들에
투자한 것으로 나타났다. 더구나 전반적인 경기침체에도 불구하고 벤처 캐피털들은 2001년 1/4 분기에만 2000년
전체와 맞먹는 5억 1,000만 달러의 자금을 지원했는데
역시 통신분야에 대한 관심이 높아서 이 중 97%가 이 부문에 투자된 바 있다. 이러한 적극적인 투자에 힘입어 MEMS 업체들의 생산 설비 확충과
전문화가 이루어지고 있으며, MEMS 분야의 기술개발, 상용화
및 장치 이용을 촉진하기 위해 회원사간 신뢰성 높은 산업 데이터를 공유할 목적으로 미국 내에서는 MIG(MEMS
Industry Group), 유럽에서는 NEXUS 등과 같은 조직을 결성하기도 하였다.
한편 광 스위치를 포함한 통신부문 관련 MEMS의 수요가
빠르게 증가하여 많은 통신분야 업체들이 관련 생산시설을 갖춘 업체들을 매입하고 있으며, 기존 반도체
생산업체들도 MEMS 제조 서비스에 뛰어들고 있는 상황이다. 게다가 MEMS 생산설비 설치비용은 반도체 설비의 1/10 정도 밖에 들지
않아서 MEMS 분야의 설비투자는 계속될 것으로 보인다. 이와
함께 MEMS 전용 생산 및 계측장비의 신제품도 최근에 많이 출시되었는데, 대표적인 생산장비 업체로는 Alcatel Vacuum Technology,
Karl Suss, Surface Technology Systems, Ultratech Stepper, Xactix 등이 있으며, 계측장비 업체로는 Veeco 및
Zygo 등을 들 수 있다.
앞으로 20년 내에
MEMS 산업을 촉진할 기술적 요인에는 생체호환(biocompatible) 재료와 기능
합성을 통한 MEMS의 통합 성능이 포함되며, 고성능 모델링
및 시뮬레이션 도구의 개발과 MEMS에 특화된 장비업체 성장 등도
MEMS의 미래에 영향을 미칠 중요한 기술적 요인이 될 것으로 보인다. 또한 도전해야 할
주요 기술적 과제로는 MEMS 제조장치의 수적 증가, 품질
및 다양성 문제, MEMS 제조공장 시험 서비스의 가용성, MEMS와의
인터페이스를 위한 재생 가능한 회로 및 MEMS 장치 설계 라이브러리 창출, 그리고 MEMS 장치의 마케팅 시간 감소를 위한 인프라 구축 등을
들 수 있다.
나. 세계 시장
2001년도 전세계 MEMS 매출액은 센서 부문 24억
9,600만 달러와 비센서 부문 14억 7,300만
달러를 합쳐 약 39억 6,900만 달러를 기록하였으며, 통신과 가전 시장의 성장에 힘입어 2006년까지 19.5%의 복합연평균 성장률을 기록하면서 96억 6,200만 달러 규모가 될 전망이다((그림 3) 참조).

한편 MEMS 시장의 성장에 대해 좀더 낙관적으로 전망하고
있는 RocSearch에서는 MEMS 시장이 2005년 약 110억 달러 규모에 이를 것으로 보고 있다. 또한 칩 수준(chip level)의 MEMS 시장 규모를 예측하고 있는 이들 시장자료 외에 좀더 포괄적으로
MEMS가 포함된 모든 상용 제품의 시장 규모를 예측하고 있는 유럽의 MEMS 마케팅 기관인 NEXUS에서는 2000년 300억
달러 규모에서 2005년까지 연평균 20%의 성장률을 기록하면서 680억 달러 규모로 MEMS 시장이 성장할 것으로 전망하고 있다.
장치별로는 관성 센서 및 압력 센서 등을 포함한 센서 분야가
2001년 24억 9,600만 달러의 매출로
전체 시장의 62.9%, Microfluidics 및 마이크로어레이 등을 포함한 비센서 분야가 14억 7,280만 달러의 매출로
37.1%를 차지하였으나, 2006년에는 비센서인 마이크로어레이의 급격한 성장에 힘입어
센서 52.5% 및 비센서 47.5%로 거의 동등하게 시장을
양분할 것으로 전망된다. 세부적으로 센서 분야에서는 2001년 55.4%의 시장점유율을 기록한 관성 센서가 2006년에도 58.4%로 계속 수위를 차지할 것으로 보이며, 비센서 분야에서는 2001년도 16.3% 시장점유율에 불과하던 마이크로어레이가 2006년도에는 41.1%의
Microfluidics를 제치고 47.1%로 앞서나갈 것으로 예측된다.
애플리케이션 분야별로는 승용차, 트럭 및 모터사이클이 포함된
자동차 분야가 2001년 12억 2,340만 달러(30.8%), PC와 주변기기가 포함된 컴퓨터 분야가 10억 4,100만 달러(26.2%),
그리고 홈 정보단말, 상용 광학기기, 농업, 환경, 에너지, 공장
자동화, 중장비, 수송, 인프라, 우주항공 및 국방 등 포괄적인 산업 분야가 10억 890만 달러(25.4%)의 매출을 기록하여 3강 구도를 형성하였다. 2006년까지 광섬유 망과 무선 핸드셋이
포함된 통신 분야가 124.2%의 복합연평균 성장률을 기록하면서 20억 2,850만 달러 규모의 시장으로 급성장하고, 의료 분야도 10억 달러 이상의 시장 규모를 기록하는 등 전분야에 걸쳐 커다란 시장이 형성될 것으로 보인다.
다. 미국 시장
MIG(MEMS Industry Group)에서 발표한 2001년도 연차보고서에 따르면, 미국의 MEMS 산업은 새로운 비즈니스 창출, 고용증대 및 신규 산업 부문으로의
애플리케이션 다양화 등을 통해 급속히 성장하고 있다. MIG는
Intel, Honeywell, Xerox, XACTIX 및 Corning IntelliSense 등
미국에 기반을 둔 22개 미세구조 설계, 제조 및 통합업체들이 MEMS 분야의 기술개발, 상용화 및 장치 이용을 촉진하기 위해 회원사간
신뢰성 높은 산업 데이터를 공유할 목적으로 결성한 조직이다. 연차보고서에서 제시한 미국 MEMS 시장의 몇 가지 주요 현황 및 전망은 다음과 같다:
- 2000년 미국 MEMS 시장 규모는 약 20억~50억 달러로 파악
- 2004년 미국 MEMS 시장 규모는 약 80억~150억
달러로 예상
- 현재 미국인 일인당 1.6대의 MEMS 장치 이용대수는
2004년까지 45%의 복합연평균 성장률을 기록하면서 5대로
증가
- 과거 3년간 연평균 10개의 MEMS 업체가
설립된 것을 포함하여 1995년부터 2001년까지 40% 이상의 증가율을 기록하면서 70개 이상의 MEMS 업체가 설립
- MEMS 산업 종사자수의 성장률이 폭발적으로
증가하여 2001년 현재 1985년 대비 30배 증가
- MEMS 업체의 45가 California를 중심으로 한 서부해안 지역에 밀집되어
있고, 북동부 지역에는 약 30%가 입주
라. 국내 시장
국내에서는 MEMS 기술의 저변이 낮고 연구인력이 부족한
상황이지만, 1980년 후반부터 대학을 중심으로 MEMS 분야의
연구가 개시되어 미국, 일본 및 유럽 등 기술 선진국과의 격차를 좁히고 있다. 1995년부터 선도기술개발 사업을 통해 초소형 정밀 기계기술 개발을 체제적으로 수행한 기틀을 마련하였으며, 1997년 산업기반기술 사업을 통해 서울대학교 반도체 공동연구소 내에
MTEC(Microsystem Technology Center)를 설립하여 국내 산학연 연구자들이 손쉽게 MEMS를 설계/제작하고 정보를 공유할 장을 마련한 바 있다. 또한 프론티어 연구개발 사업의 일환으로 2000년부터 10년간의 지능형 마이크로시스템 과제를 통해 체내 자율주행 내시경과 극소형 마이크로 PDA 개발에 약 2,000억원의 연구비가 투입되는 등 다양한 국책
프로그램을 통해 MEMS 기술 개발이 활성화되고 있다.
현재 국내에서는 1995년부터 추진해온 초소형 정밀 기계기술개발
사업에 참여한 삼성전자, 메디슨, 삼성전기, 한국전자 및 케피코 등이 잉크젯 헤드, 의료용 내시경, 고집적HDD, 대면적 디스플레이용 마이크로 반사경, 캠코더용 자이로 센서, 자동차용 압력 센서 등 다수 제품을 개발하여
상용화하였고, 삼성전자, 오리온전기, 동양산전, 한국코어 및 대우전자 등이 실리콘 미세가공을 위한 SOI 및 Isolation 기술,
미세방전 가공기술, 미세가공 접합 및 패키징 기술, 자기변형
박막가공 및 응용기술, 진공 전자소자용 접합기술, 그리고
표면 미세가공 기반기술 등 6개 기술을 개발 완료하였다.
또한 이 사업을 통하여 정보통신 및 의료분야에서 마이크로솔루션스, 엠투엔, 엠플루이딕스, MEMSware 및 아이큐리랩 등 20여 벤처기업의 창업과 이들의 기술기반 구축을 지원한 바 있다. 국내
시장에서는 현재 대기업과 함께 벤처기업이 공동으로 휴대단말기용 고주파부품, 광통신용 부품 및 모듈, 적외선 이미지 센서, 그리고 반도체 검사용 프로브 카드 등을 개발하고
있는 상황이기 때문에 구체적인 국내시장 규모 파악은 시장이 본격적으로 형성되기 전에는 어려울 것으로 보인다.
한편, 2001년 40여
개에 달했던 MEMS 벤처기업은 2002년에 들어와 약 20% 정도가 타 업종으로 전환하거나 도산한 것으로 파악되고 있는데, 이러한
현상은 대내외적인 MEMS 기술 산업화가 더디게 진행되면서 국내 벤처기업들이 아직까지 뚜렷한 수익원을
창출하지 못한데다 지난해 이후 창업투자회사 등이 단기적으로 자금회수를 할 수 있는 종목으로 투자 정책을 전환하면서 신규 자금유입이 사실상 중단된
것이 크게 작용한 것으로 보인다.
4. 결론 및 시사점
MEMS 기술은 21세기 사회에서 보다 많은 사람들이 쉽게 정보를 습득하도록 하고, 인간의
삶을 환경과 보다 친숙하도록 하여 인간에게 첨단 복지사회를 현실화 시켜줄 것으로 전망된다. MEMS 기술은
모든 제품의 소형화, 저가격화, 고부가가치화를 통해 전산업
분야에 새로운 기회를 제공할 것이고, 특히 정보 인프라와의 결합을 통해 엄청난 시너지 효과를 발휘할
것으로 전망된다. MEMS 기술에 의해 모든 기기가 초소형화 될 경우 전자공간과 물리공간이 연결되는
진정한 유비쿼터스(ubiquitous) 사회가 구축될 수 있다.
현재 전세계적으로 다양한 MEMS 응용제품이 출시되는 초기
시장단계를 거치고 있으며, 앞으로는 MEMS 기술과 VLSI의 접목으로 응용분야의 급격한 확대와 시장 규모의 비약적인 성장이 예상되고 있다. MEMS 산업은 새로운 비즈니스 창출, 고용증대 및 신규 산업 부문으로의
애플리케이션 다양화 등을 통해 앞으로 5년 이내에 약 100억
달러 규모의 거대한 시장을 형성할 것으로 전망되고 있다. 이러한
MEMS 산업의 성장을 가속화 하기 위해서는 표준화를 통해 기본적인 라이브러리를 설정하여 MEMS 제품을
설계할 수 있도록 하고, 이를 기반으로 분업화를 통한 생산기술 확보와 신기술 개발이 함께 이루어져야
할 것이다.
앞으로 기존 기계 부품들이 MEMS 공정을 거쳐야 하는
시대가 본격적으로 도래하면 MEMS가 국가 기술산업의 근간이 될 것이고, MEMS 공정을 거친 부품이 없이 우리나라가 4대 차세대 중점기술
육성분야로 선정한 IT(정보기술), ET(환경기술), BT(생명공학기술), 그리고
NT(나노기술)의 발전은 기대할 수도 없다는 지적이 나오고 있다. 다행스럽게도 MEMS 기술을 이용한 광부품 개발 업체인 엠투엔을
비롯하여 인텔리마이크론스, 엠에스에스 등 국내 30여 개의 MEMS관련 벤처기업들이 MEMS기술연구조합을 설립하여 정부에 인프라
구축에 대한 건의를 활발히 개진하고 있는 상황이다. MEMS 기술연구조합은 그 동안 연구개발 수준에
머물러 있는 국내 MEMS기술을 민간 주축으로 산업화 단계로 끌어 올린다는 목표 아래 응용시장 개척
등을 위한 참여사간 공동 커뮤니티를 형성하는 한편 MEMS기술 촉진과 시장활성화를 위한 정부의 지원책을
촉구하는 업계의 창구역할을 맡게 된다.
또한 MEMS 기술연구조합의 회원사들은 2002 내에 MEMS 부품 시제품 시험 및 양산을 위한 MEMS전용 FAB을 공동으로 구축/운영함으로써
그 동안 MEMS기술 산업화의 최대 걸림돌이었던 초기 인프라 투자부담을 크게 낮춘다는 계획을 가지고
있다. MEMS 기술로 제조되는 미세 부품들은 기존 반도체용 실리콘 웨이퍼 공정을 이용할 수 있어 세계적인
반도체 생산 인프라를 구축한 우리나라가 조금만 관심을 기울인다면 조속한 시기에 MEMS 전용 FAB을 구축할 수 있을 것으로 생각된다.
MEMS 산업은 이제 막 도약을 시작한
산업이므로 국내 업체가 진입하여 성공할 기회가 충분히 있으며, MEMS 기술은 반도체 공정과 비슷해
반도체 제조에 강한 우리나라가 기존의 인프라를 잘 활용한다면 충분히 세계 시장을 주도할 수 있을 것으로 전망된다.
실리콘 기반 압력 센서 기술 동향
천재영* 조평동**
1961년 실리콘 기반 센서가 시연된 이후 최신의 반도체 기반 센서는 부품의 소형화와 다기능화가 가능해졌다. 과거 기계식 센서에 비해 반도체 기반 센서는 정확도와 제품간 편차가 적은 양질의 센서를 개발할 수 있게 되었다. 또한 반도체 기반 센서는 외부 환경의 변화에 따른 반응속도가 빠르고 실측된 데이터를 컴퓨터나 기계가 인식할
수 있는 전기적 신호로 변환하여 주기 때문에 산업, 서비스, 학계에서
널리 사용되고 있다. 본 고에서는 온도, 가스, 압력, 가속도, 위치
등을 인식하는 다양한 센서 중 전세계적으로 가장 활발하게 연구가 진행 중인 압력 센서에 대해 다루며, 각국의
동향 및 국내 현황에 대해 다룬다. 또한 현재 실리콘 기반 반도체 센서에 대해 소개하였으며 마지막으로
향후 전망에 대해 다루고자 한다. ▧

I. 서 론
인간이 느낄 수 있는 모든 감각을 센서로 다루기란 어려운 일이며 현대의 센서 부품들은 자기ㆍ변위ㆍ진동ㆍ가속도ㆍ회전 수ㆍ유량ㆍ유속ㆍ액체성분ㆍ가스성분ㆍ가시광ㆍ적외선ㆍ초음파ㆍ마이크로파ㆍ자외선ㆍ방사선ㆍ엑스선 등 몇몇 물리량을 전기적인
신호로 검출해 산업 현장, 서비스업, 의료업, 학계에서 활용하고 있다. 일반적으로 검출기라 하면 온도ㆍ압력ㆍ습도 등 여러 종류의 물리량을
검지ㆍ검출하거나 판별ㆍ계측하는 기능을 갖춘 소자로
흔히 센서라고도 한다. 센서에서 검출된 신호를 전기적 신호로 변환하여 마이크로 컨트롤러나, 컴퓨터가 인식할 수 있는 신호의 형태로 증폭, 축적, 조작 등을 걸쳐 응용 애플리케이션에 맞게 활용할 수 있다. (그림 1)은 센서가 외부 시스템으로부터의 물리적, 역학적, 화학적 정보를 검출기가 감지하여 최종 컴퓨터단에서 인식할 수 있는 형태의 전기적 신호로 변환하는 프로세스를
블록다이어그램으로 도시화한 예이다.

센서는 응용 방법에 따라 자연재해 방지, 생태환경 감시, 도난 및 위험 감시, 에너지 자원감지, 자동화 시스템 및 가정의 홈오토메이션 구축에 응용할 수 있다. 예를
들어 진동을 감지하는 센서를 교통량이 많은 교량이나 고가도로에 설치하여 지진이나 홍수로 인한 균열 등을 감시하며 예측할 수 없는 불의의 사고로부터
인명안전을 위해 활용할 수 있다. 또한 진동 센서의 경우 먼 바다에서 발생하는 미세한 진동도 감지할
수 있어 지진 해일과 같은 미세한 환경변화도 감지하여 위험 수위를 예보하는데 활용할 수 있다. 뿐만
아니라 사람이 항상 감시할 수 없는 생물체의 서식지 특성을 분석하거나 이동경로를 추적하는 데에도 센서 위치 인식 센서를 이용할 수 있다. <표 1>는 현재까지 개발된 센서에 대해 용도별로 항목을
정리한 것이다. <표 2>는 응용 분야별 센서의
최종 사용처를 기준으로 항목을 정리한 표이다.

II. 센서 기술의 발전 동향
초창기 반도체 센서가 개발되기 이전에는 기계식 센서가 주를 이루었다.
1950년대 이후로 Bell Technology
Lab을 중심으로 Honeywell,
Westinghouse 등지에서 실리콘 센서 제조에 핵심적인 기술을 확보하기 위하여 기초 연구가 진행되었다. 1970년대부터 학계에서도 실리콘 기반 센서의 연구개발이 진행되었으며
1990년대부터는 국가적인 과제로 각국에서 앞다투어 기술개발이 진행되었다.
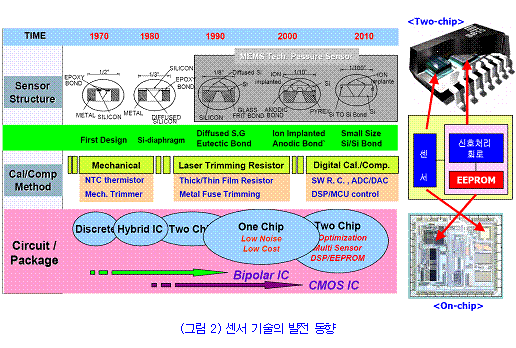
최신 대부분의 센서는 1 마이크론 정도로 매우 소형화 되어
있다. 1 마이크론은 백만분의 1 미터로 인간의 머리카락의
굵기가 대략 80 마이크론 정도이므로 1 마이크론은 육안으로는
식별이 사실상 불가능하다. 일반적으로 MEMS(Micro
Electro Mechanical System) 기술로 일컬으며, MEMS 부품이란 수십에서
수백 마이크론 크기의 아주 작은 기계적인 구조물을 마이크론 단위의 정밀도로 가공하고 여기에 전자회로를 결합 또는 집적화시켜 원하는 기능을 수행할
수 있도록 만든 초소형 시스템을 말한다. (그림 2)에서
보았듯이 MEMS 기술의 변천사를 살펴보면 아래와 같다.
¡ 1950~1960 기술개발 단계(Discovery)
- 1954: Smith
discovers piezoresistivity at Bell Labs
- 1958:
Discrete silicon strain gages commercially available
¡ 1960~1970 상용화 및 시장 개발 단계(Evolution)
- 1961:
Integration of strain gages into silicon diaphragm(Kulite)
- 1966:
Mechanically milled cavity introduced(Honeywell)
- 1970:
Isotropic micromachined window introduced(Kulite)
- 1970: First
piezoresistive acceleration sensors developed(Kulite)
¡ 1970~1980 비용절감과 애플리케이션 확장 단계(Application &
Expansion)
- 1971: Sensors
employing anodic bonding introduced(Kulite)
- 1974: First
high volumn hygrid sensor(National Semiconductor)
- 1976:
Anisotropic micromachined windows introduced(Kulite)
- 1976: First
under-hood automotive silicon sensor(Honeywell)
- 1977: First
silicon capacitive pressure sensor demonstrated(St anford Univ.)
- 1978: Bossed
silicon diaphragms introduced(Endevco)
- 1979: Passive
on chip temperature compensation(Kulite)
- 1979: Ion
implantation of strain gages(Honeywell)
¡ 1980~1990 소형화 및 시장 활성화 단계(Full
Commercialzation)
- 1982: First
disposable medical transducer(Foxboro/ICT, Honeywe ll)
- 1982: Active
on chip signal conditioning(Honeywell)
- 1985:
Polysilicon diaphragm sensor by additive process(Wisconsin Univ.)
- 1987: Si-Si
and Si-SiO2 lamination implemented into sensor designs(NovaSensor)
- 1988: SFB based acceleration sensor with 1000:1
overload protec tion(NovaSensor)
- 1990:
Introduction of SenStable: new superstable piezoresistive process/design
(NovaSensor)
과거 MEMS 기술개발 과정을 살펴보면, 마이크로 메커니즘 영역에서 기술개발이 진행되어지다 보니 현실 세계의 중력이나 관성력보다는 원자간의 인력이나
표면 장력에 의한 효과에 더욱 영향을 받기 때문에 기술개발이 더디었다. 또한 전자, 기계, 재료 및 회로 기술이 융합된 것으로서 고장의 발견 및 진단이
쉽지 않았다. 그럼에도 센서 부품개발은 꾸준히 지속되어 왔으며 현재 대부분의 센서들<표3>이 각 업체에서 다양하게 개발되어 있어 최종 사용자에서는
응용 목적에 따라 선택할 수 있다. <표4>는
연도별 센서 시장 규모에 관한 예이다.
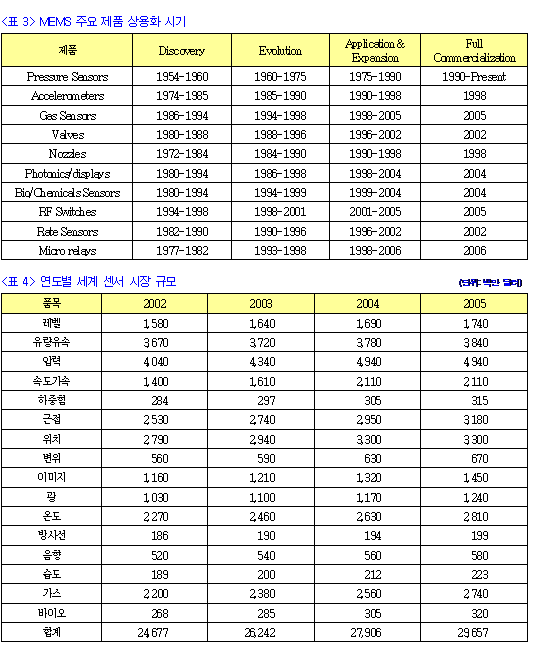
III. 실리콘 센서의 기술 동향
MEMS 기술개발의 역사는 불과 20년이 채 안되지만 눈부신 기술 발전이 이루어졌다. 외국의 경우 MEMS를 국가 차원에서 확보해야 할 중요한 기술로 인식하고 연구개발에 과감한 투자를 시행하였기에 가능한 결과라
볼 수 있다. 미국의 경우 NSF(National Science
Foundation)나 DARPA(Defence Advanced Research Project
Agency), NASA, DOE(Department of Energy) 등에서 MEMS 분야의
연구를 지원해 왔다. 이처럼 산학연간의 긴밀한 공조 하에 체계적인 기술개발이 진행되어 옴에 따라 다양한 MEMS 상품들을 출시하고 있다.
최근 들어 산업계에서 MEMS 분야의 시장성을 높게 평가하여
인텔과Corning, Honeywell, Xactix, Xerox 등
5개 회사는 MEMS 산업 분야의 교역을 지원할 특별그룹인 ‘MEMS Industry Group(MEMS-IG)’을 신설하였으며, MEMS 기술의 발달 상황과 시장 정보를 제공하고 있다. 2000년대에
들어서는 바이오, 복지, 광통신, 무선통신용 핵심소자 분야에 집중 투자하고 있다. 한 가지 주목할
만한 점은 캘리포니아주가 MEMS 기술개발의 세계적 클러스터가 되고 있다는 점이다. 캘리포니아주에는 유력 대학이나 대기업도 많지만 풍부한 벤처 캐피탈에 지지를 받은 무수한 벤처 기업이 존재한다. 기술 분야별로 보아도 캘리포니아주는 마이크로 유체, 광 스위치, RF 분야 등의 업체 수가 다른 주에 비해 훨씬 많다. 실리콘밸리의
마이크로일렉트로닉스와 바이오테크놀로지, 로스앤젤레스 지구의 국방ㆍ항공, 샌디에고의 바이오테크놀로지와 무선통신 관련 기업의 집중이 MEMS의
이노베이션을 견인하고 있다고 할 수 있을 것 같다.
유럽은 미국, 일본에 비해 상대적으로 늦게 출발하였으나 1994년부터 NEXUS 등과 같은 네트워크를 구축하여 관련 연구
기관과 산업체 간의 정보 교환, 공동 연구 컨소시엄 형성 등을 통해 활발한 연구개발을 진행 중이다. NEXUS 외에도 EC Europractive IST 프로그램의
일환으로 유럽의 8개 MEMS 및 마이크로시스템 R&D 센터를 포함하는 MEMSOI를 형성하고 있다. MEMSOI에서는 유럽
업체들이 새로운 부품을 추진하는 데에 소요되는 개발 시간과 비용을 단축시키기 위해 입증된 마이크로시스템 기술의 네트워크 획득을 촉진시키고 있다.
일본은 1991년
시작된 Micromachine Project(1991~2000년,
10년간 250억 엔 규모)를 계기로 본격적으로
시작하였다. 이 사업은 통상산업성이 주도가 되어 국가적 차원에서 지원이 이루어지고 있으며, 대부분의 연구개발 자금은 MMC(마이크로머신 센터)를 통해 주요 기업체의 기술개발 활동에 집중 투자되고 있다. 미국에서의 MEMS 연구를 반도체 공정을 이용한 Lithography- based MEMS로 정의할 수 있다면 일본의 경우는 이것에 더하여
Mechatronics가 가미된 마이크로머신(기존의 크고 비싼 기계가 할 수 있는 많은
일을 마이크로머신이 대신할 수 있다는 생각에서 출발)으로 정의하여
MEMS 개발을 추진하고 있다. 또한 미국의 경우 대학과 연구소를 중심으로 기술이 발전하여
수많은 벤처기업으로 발전하는 양상을 보이는 반면, 일본의 경우 기술 발전에 기업이 중추적인 역할을 하고
있다는 점이다.
국내의 경우 기술 선진국에 비해 저변이 낮고 연구 인력도 부족한 상황이었으나 80년대 대후반에 대학을 중심으로 MEMS 분야의 연구가 시작되었으므로, 시기적으로 큰 격차가 나지 않는다고 볼 수 있다. 이후 1995년 정통부의 선도 기술개발 사업을 통해 초소형 정밀기계 기술개발을 체계적으로 수행하기 시작하였고, 과기부의 프론티어 연구개발 사업의 일환으로 2000년부터 10년간 지능형 마이크로시스템 과제를 통해 체내 자율 주행 내시경과 극소형 마이크로 PDA 개발에 약 2,000억 원의 연구비를 투입하는 등 다양한 국책
프로그램을 통해 MEMS 기술개발이 활성화되고 있는 추세이다. 산업계에서는
삼성전자와 LG전자가 주요 연구 개발을 하고 있으며, 여러
중소기업에서도 MEMS 센서류 등을 개발 및 상용화하고 있는 단계에 있다. 한국은 세계 최고 수준의 반도체 기술과 통신 기술 및 시장을 확보하고 있다.
또한 국가 핵심 산업 분야인 자동차, 정보통신, 바이오/환경, 가전 등의
육성 전략에 따라 반도체 기반 기술을 Nano/MEMS 기술과 접합 시 우수한 시너지 효과가 나타날
가능성이 매우 높다. 그러나 아직 원천 기술 및 개발 기술의 산업화 연결 체계가 미흡하고, 인프라 부족과 MEMS 분야 산업 구조가 영세한 단점을 극복해야
하는 과제가 있다.

이미 앞서 살펴본 바와 같이 인간의 오감과 비슷한 센서의 종류 또한 다양하고 그 용도와 목적에 따라
센서를 구성하는 부품의 소재까지 다르게 된다. 본 기술 동향지에서는 다양한 종류의 센서중에서 현재 각
산학계에서 활발히 연구중인 압력 센서를 기반으로 최신 센서의 기술 동향을 소개하고자 한다. <표 5>는 용도별 센서를 구성하는 소재 리스트 목록이다. 또한 <표 6>는 센서 분류 방식에 따른 센서의 종류를 나열하였다.
압력을 간단히 정의하자면 압력은 물질이 인접하는 각 부분에 서로 미치는 힘의 크기를 나타내는 양이며
단위 면적당 작용하는 면과 법선 방향의 힘을 말한다. 고체 내에서는 압력에 따른 유동이 없으므로 힘의
방향성이 유지되지만 유체(기체, 액체)는 힘이 가해지는 방향에 따라 자유롭게 형을 바꾸어 유동하므로 압력은 방향성이 없고 임의 점에서 어느 방향의
면에 대해서도 같은 크기의 압력이 작용된다. 최근에 개발되어진 대부분의 압력 센서들은 기계적인 변위를
전기신호로 변환하는 것으로, 외부압력을 응력으로 변환하는 다이어프램과 다이어프램에서 발생하는 동력을
전기신호로 변환하는 방법을 이용한다.
압력 센서는 프로세스 또는 시스템에서 압력을 측정하는 소자로서 공업계측, 자동제어, 의료,자동차
엔진제어, 환경제어, 전기용품 등 그 용도가 다양하고 가장
폭넓게 사용되는 센서중의 하나이다. 압력 센서의 측정원리는 변위, 변형, 자기-열전도율, 진동수
등을 이용하는 것으로 현재 많은 종류가 실용화되어 사용되고 있다. 최근에는 반도체 기술과 마이크로머시닝
기술의 발전으로 보다 소형화되고 복합화된 다기능의 스마트 센서에 대한 관심이 높아지고 있다. 현재 시장에서
구할 수 있는 압력 센서의 종류 및 특성을 살펴보도록 하겠다.
1. 기계식 압력 센서
기계식 압력 센서에도 많은 종류가 있지만 대표적인 것은 부르돈관, 다이어프램, 벨로우즈이다. 그 중에서도 탄성식의 부르돈(Full Dorne)관은 현재 가장 많이 사용되고 있는 것으로 단면이 원상 또는 평면상의 금속 파이프이고 개방된
고정단으로부터 측정압력을 도입하면 다른 밀폐된 관의 선단이 이동하는 원리를 이용하고 있다. 이 관선
이동량은 관내의 압력 크기에 비례하므로, 이동량은 기계적으로 확대된 압력을 지시한다. 다음으로 많이 사용되고 있는 것이 다이어프램과 벨로우즈로 전자는 압력차에 비례한 원판의 휨 정도로, 후자는 원통 내부와 외부의 압력차에 의해 주름상자가 신축하여 그 변위량이 압력차에 비례하는 것으로부터 각각
압력을 측정한다.
2. 전자식 압력 센서
전자식 압력 센서의 대부분은 기계적인 변위를 전기신호로 변환하는 부분이 기계식과 다를 뿐 기본적으로는
기계식과 동일하다. 용량형 압력 센서는 2개의 물체(전극)간의 정전용량 변화로부터 그 사이의 변위를 측정하는 방법을 기본적으로
이용한다. 이 외에도 스트레인게이지를 이용한 압저항형, 유기
또는 무기압전소자를 이용한 압전형 그리고 LVDTㆍ인덕티브타입의 코일형이 있으며
최근에는 초고온의 환경이나 원격감 등의 목적으로 광섬유나 광격로차를 이용한 광학형 압력 센서가 개발되어 사용되고 있다. 이 중에서도 스트레인게이지를 이용한 압저항형 센서가 성능이나 가격 면에서 우위를 점하고 있어 가장 많이 사용되고
있다.
3. 반도체식 압력 센서
반도체 압력 센서는 최근에 실용화가 가속되고 있는 센서로 크리프 현상이 없고 직선성이 우수하며 소형ㆍ경량으로 진동에도 매우 강한
것이 특징이다. 또한, 기계식보다 고감도, 고신뢰성이며 양산성이 좋다. 이것은 압력을 왜(歪)응력으로 변환하는 다이어프램과 다이어프램에서 발생하는 동력을 전기신호로
변환하는 두 부분으로 구성되어 있다. 다이어프램은 단결정 실리콘을 화학적으로 에칭하여 형성하며, 다이어프램에서 발생하는 응력을 전기적인 신호로 변환하는 방법으로 진동자의 고유진동수 변화와 표면탄성파를 이용하는
것도 있으나, 주로 압저항식과 정전용량식의 두 종류가 가장 많이 사용되고 있다. 이중 압저항식은 저항확산식 또는 확산식이라고도 하는데 압저항소자를 형성시킬 때에 반도체의 불순물 확산공정이
이용되기 때문이다. 정전용량식은 서로 마주보고 있는 전극판의 간격을 외부로부터의 응력에 의하여 변화시키면
전극간의 정전용량이 변화한다. 이 정전용량 변화를 전기신호로 변환시키면 응력이 검출된다. 정전용량식은 압저항식에 비해 고감도이나 전극의 형성, 외부회로와의
연결이 복잡한 구조로 되어 있고 응답성이 나빠 수요는 적다. 그러나 온도 특성이 우수하고 소형이며 고감도인
관계로 생체 등 미압의 영역에서 사용할 때는 이점이 많다. 이 외에도 다결정실리콘 압력 센서는 변형
게이지가 다결정 Si박막으로 되어있고 다이어프램이 금속 위에 만들어져 있어서 측정압력의 범위를 확대시킬
수 있다. 또 고온과 부식성 분위기 등의 약환경하에서도 사용할 수 있는 SOS(Silicon On Sapphire) 압력 센서가 있다. 이것은
사파이어 기판 위에 실리콘 박막을 에피텍셜 성장시켜, 이 SOS막을
검출소자로 이용하는 센서이다. (그림 3)은 정전용량형 압력
센서의 예이다.
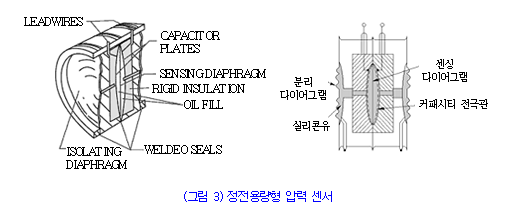
4. 실리콘 압력 센서
1961 년 실리콘 압력 센서가 처음
시연된 이후 Honeywell 사에서 센서와 신호처리부가 집적화된 실리콘 압력 센서를 1983 년 처음으로 출시하였다. 그 후 1988 년에 Nova Sensor 사에서는 웨이퍼 접합 기술을 이용하여
일괄처리공정(batch process)에 의한 압력 센서를 처음으로 생산하였다. 우리나라에서는 2002 년에 신호처리회로가 집적화된 자동차 흡기압(MAP) 압력 센서의 양산체제가 산업체에서 처음으로 구축되었다. (그림 4 (좌))는 실리콘 압력 센서의 단면 사진이다. 이 센서 칩의 크기는 0.65×0.65mm로서 150mm 웨이퍼 한 장에 24,000개의 센서 칩을 만들 수 있다. (그림 4 (우)) 프리스케일(사)의 MPXY8000 Series
센서로 공기압과 온도를 동시에 측정할 수 있다.
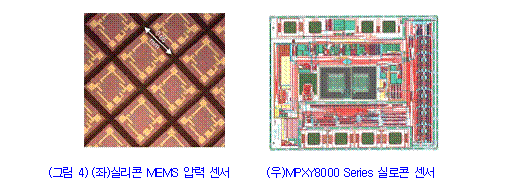
압력 측정용 실리콘 압력 센서 혹은 압전형 실리콘 센서로 일컬어지는 센서는 계장설비 및 기계제작 그리고
자동화, 생산공정제어와 환경 모니터링에 적합한 센서로서, 진동과
내맥동이 심한 환경에서 높은 특성을 보여준다. 이 센서는 -40°~125° 사이의 온도에서 액체 및 가스 등의 매체들을 0.1350kgf/cm의 압력 범위에서 압력 측정에 사용되며, 이
센서의 특징으로서 높은 직선성과 주파수 범위, 영향을 받지 않는 히스테리시스(Hysteresis) 등으로 고정밀 측정에 적합한 센서이다. 실리콘
압력 센서는 외부에서 압력이 가해져 생기는 압저항 효과(Piezoresistive effect)에 의해
응용 반도체에 압력이 인가되면 저항값이 변하는 현상을 이용한다.
압전 현상이란 어떤 종류의 결정판에 일정한 방향에서 압력을 가하면 그 외력에 비례해서 양전 또는 음전하기
때문에 나타나는 현상이다. 압전 현상은 1880년에 피에르와
폴 자크 퀴리 형제에 의해 발견되었다. 그들은 석영, 전기석, 로셀염과 같은 결정에 어떤 결정축을 따라 압력을
가하면 결정의 표면에 전압이 생기는 것을 관측하였다. 다음해에도 그들은 전류를 가하면 그 결정들의 길이가
늘어나는 역효과도 관측하였다. 일반적으로 한 장의 결정판에 의한 압전기는 극히 미약하지만 금속박을 삽입하여
익서를 여러장 겹치면 그 전기량을 충분히 측정할 수 있게 된다. 이를 압전 효과라 하는데 이를 이용하면
기계적인 변형을 전기적으로 꺼낼 수 있어 마이크로폰이나 전축용 픽업 등에 이용할 수 있게 된다. 여기에는
압전율이 큰 로셀염의 결정을 많이 쓰게 된다. 간단히 말해서 일정한 방향의 압력을 어떤 종류의 결정판에
가하면 그 압력에 비례하여 양전하 또는 음전하가 발생하게 되는 것이다.
(그림 5)와 (그림 6)은 실리콘 압력 센서와 정전용량형 실리콘 압력 센서에 관한
예이다. (그림5)는 일반적인 실리콘 압력 센서의 기본 구조이다. (상)에서는 유리 기판에 압력을 도입하는 큰 홀(hole)이 만들어지는 반면, (하)에서는
실리콘 기판과 유리기판 사이를 진공으로하여 밀봉된다. (그림 6)은
정전용량형 실리콘 압력 센서의 블록 구조이다. 압력을 감지하는 정전용량형 센서는 하부 전극과 폴리실리콘
다이어프램 사이에 형성된다. 압력이 가해지면 탄성체인 폴리실리콘 멤브레인이 휘어져 정전용량이 변하게
되는 원리를 이용한다. 높은 분해능을 갖는 센서를 구현하기 위해 거의 동일한 용량을 갖는 기준 셀(Reference Cell)을 다수(14개)의 셀을 어레이 구조로 설계하여 센싱 감도와 SNR을 개선시킬 수
있다. (그림7)은 온도 변화에 따른 실리콘 압력 센서의
출력 전압에 관한 그래프이며, 온도가 최대 약 125°에서도
센서 분해능 감도의 변화폭이 크지 않음을 알 수 있다.
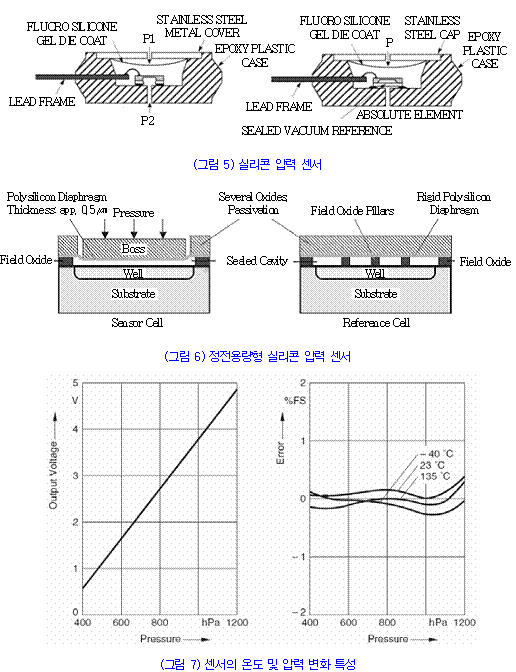
IV. 결 론
1960년대 센서라는 용어가 처음 등장한
이후로 여러가지 표현으로 센서가 정의되어 왔지만 일반적으로 측정 대상물의 정보를 측정하여 전기적인 신호로 변환하는 장치로 정의되며 온도, 압력, 유량, 화학, 진동, 소음, 빛 등의
상태 정보를 검출할 수 있다. 2002년 세계 시장 규모는 247억
달러 정도이다. 센서를 포함한 unit나 module을 포함하면 시장은 더 클 것이다. 해마다 시장규모는 커지고
있고, 가장 규모가 큰 것은 압력 센서이다. 압력 센서는
각종 시스템에서 압력을 측정하는 소자로서 공업계측, 자동제의, 의료, 자동차 엔진 제어, 전기용품 등 그 용도가 다양하고 폭넓게 사용하는
센서 중의 하나이다. 압력 센서의 측정 원리는 변위, 변형, 열전도율, 진동수,등을
이용하는 것으로 현재 많은 종류가 실용되어 사용되고 있다. 최근에는 반도체 기술과 마이크로머시닝 기술의
발전으로부터 소형화되고 복합화된 다기능의 스마트 센서에 대한 관심에 커지고 있다. 압력을 검출하는 방식으로
크게 분류하면 기계식, 전기식, 반도체식으로 분류할 수 있으며, 점차 반도체 압력 센서의 비중이 높아지고 있다. 반도체 산업의 성장은
지수 함수적인 급격한 집적도의 향상에 힘입은 바 크며, 그 결과 대형의 고가 시스템들이 점차 작고 더
우수한 성능의 저가 집적회로로 대체되었다. 앞으로 다가올 미래 사회에서 반도체 산업은 순수한 집적도
증가보다는 다기능화의 방향으로 발전할 것이 분명하다.
<참 고 문 헌>
[1] 삼성종합 기술원 좌성훈 박사(shchoa@samsung.com), 상용화 관점에서 바라본 MEMS 산업현황, 2005.
[2] 한국에너지 기술연구원 한상도
박사, “에너지이용 센서 및 소재 기술
동향,” 2005.
[3] 고려대학교, cie.koera.ac.kr/microsensor/notefile/sensor/8-1.pdf, 2003. 5.
[4] 전자부품연구원 박효덕, “NEMS/MEMS 기술,”
[5] 한국전자부품연구원, “비접촉식 전기용량센서,” 2004.
[6] S.M. Sze, Semiconductor
Sensors, John Wiley & Sons, Inc.
[7] J. J. Carr, Sensors and
Circuits, PTR Prentice-Hall, Ltd.
[8] Ranjit Singo, Low Lee Ngo,
Ho Soon Seng, Frederick Neo Ghwee Mok, “A Silicon Pizoresistive Pressure Sensor,” IEEE Computer Society, 2002.
